光學干涉薄膜檢測技術是利用干涉現象來量測薄膜的光學常數,包括折射率(n)、消光係數(k)以及厚度(d)。其原理為:當光線垂直或以斜向入射至薄膜時,經薄膜上下界面反射(或透射)的光波,由於光程差而產生干涉現象。
光程差可表達為:δ = (2π / λ) · (n − ik) · d · cosθ
該光程差與薄膜的光學常數、入射波長及入射角密切相關;當光程差符合建設性或破壞性干涉條件時,反射光的強度會出現增強或減弱的情形。隨波長改變的光強變化即形成干涉現象,而光譜的疏密程度與薄膜的光學厚度(折射率(n)乘以厚度(d))密切相關。![光學干涉薄膜檢測技術 光學干涉薄膜檢測技術]()
![光學干涉薄膜檢測技術 光學干涉薄膜檢測技術]()
光程差可表達為:δ = (2π / λ) · (n − ik) · d · cosθ
該光程差與薄膜的光學常數、入射波長及入射角密切相關;當光程差符合建設性或破壞性干涉條件時,反射光的強度會出現增強或減弱的情形。隨波長改變的光強變化即形成干涉現象,而光譜的疏密程度與薄膜的光學厚度(折射率(n)乘以厚度(d))密切相關。
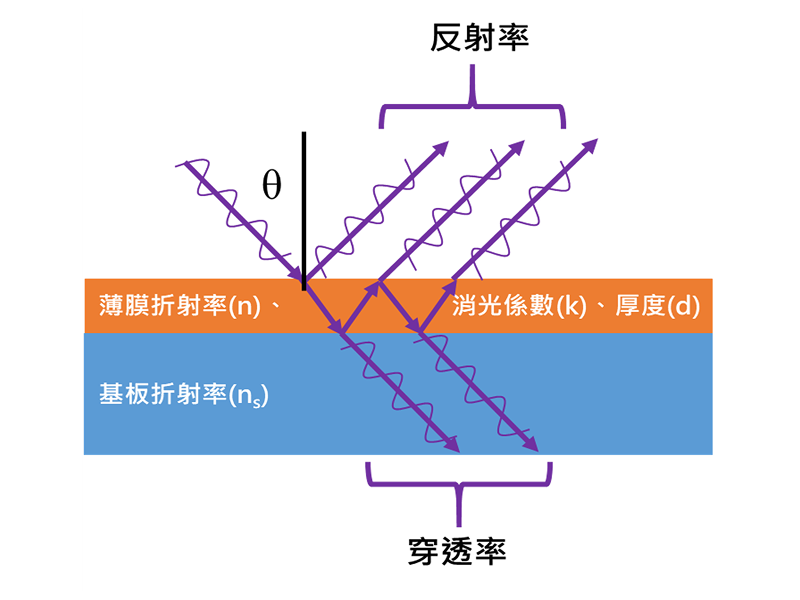

光學常數的求解方法主要有「包絡法」與「光譜擬合法」兩種:
光譜擬合法由於可使用大量光譜資料點,具有更高的準確性與適用性。
- 包絡法
此法透過干涉條紋中的波峰與波谷資料進行計算,適用於吸收極低的透明薄膜。然而對於膜厚過薄的薄膜,由於無明顯干涉條紋,將無法進行分析。 - 光譜擬合法
此方法透過建立理論模型來擬合光譜數據,進而計算出薄膜在不同波長下的折射率n(λ)和消光係數k(λ)。依薄膜的材料特性,可選擇不同模型,如:
◆ Cauchy 模型:適用於吸收極低的透明氧化物薄膜;
◆ Tauc-Lorentz 模型:適用於具有中等吸收的半導體或化合物薄膜;
◆ Drude 模型:用於描述金屬或自由載子行為的薄膜。
◆ Tauc-Lorentz 模型:適用於具有中等吸收的半導體或化合物薄膜;
◆ Drude 模型:用於描述金屬或自由載子行為的薄膜。
光譜擬合法由於可使用大量光譜資料點,具有更高的準確性與適用性。
i-Spec 分 析 軟 體
TIM 系列儀器搭配專業的 i-Spec 分析軟體,針對光譜量測結果進行精確分析,支援單層、多層及獨立膜層等各類薄膜結構計算。軟體採用模組化設計,具備高度客製化能力,可依不同應用需求調整功能配置,全面滿足客戶的量測與分析需求。
![光學干涉薄膜檢測技術 光學干涉薄膜檢測技術]()
![光學干涉薄膜檢測技術 光學干涉薄膜檢測技術]()
TIM 系列儀器搭配專業的 i-Spec 分析軟體,針對光譜量測結果進行精確分析,支援單層、多層及獨立膜層等各類薄膜結構計算。軟體採用模組化設計,具備高度客製化能力,可依不同應用需求調整功能配置,全面滿足客戶的量測與分析需求。


